Attolight社の、SEMとカソードルミネッセンス光学系を完全一体化した、世界唯一の低温・超高感度カソードルミネッセンス顕微鏡システムです。
面倒な光学調整が一切不要の独自光学設計で、DUV-NIRまでをカバー、歪のない広い観測視野、高速スペクトルマッピング、低温測定を実現。さらにストリークカメラと組み合わせて、ピコ秒時間分解測定も実現。
基礎研究・開発から品質管理など産業用途にまで対応する、これまでのCL-SEMの常識を覆す顕微鏡システムです。
特長
- 電子レンズと高NA (0.71)光学対物レンズを一体化
- SEM像と同一視野のCL像を観察
- 面倒な鏡調整は一切不要
- 超高感度・高速マッピング測定
- 歪みのない広い観測視野:~ 300 μm
- SEMとCLを統合的に操作・測定
- 観測波長:180 nm ~ 1.6 um
- 高精度6軸ステージ
- 低温測定:10 K ~
- パルス電子源によるピコ秒時間分解測定
- フォトルミネッセンス(PL)測定
用途
- LED材料の評価
- ワイドギャップ材料の評価(GaN, SiC, Ga2O3)
- 太陽電池やパワーデバイスなどの開発、品質管理、故障解析
- ナノスケール光デバイスの評価 (プラズモニクス)
- キャリアの蛍光寿命やダイナミクス観察
- EBIC像/CL像/SEM像の同時複合測定
測定例
ウェハー分析:6インチGaNウェハーの全面及び局所マッピングイメージ

GaNウェハー全面の
カソードルミネッセンス
強度イメージ(362 nm)
*測定時間:約15分
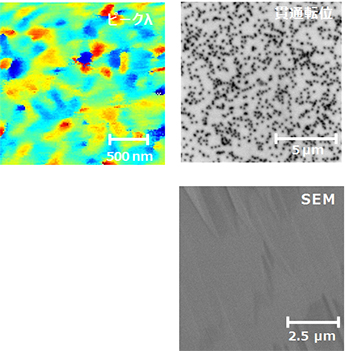
各種局所イメージ
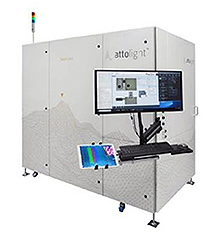
ウェハー専用モデル外観
欠陥評価:エピタキシャル層の欠陥計数

カソードルミネッセンス強度イメージ(365 nm)
GaNの貫通転位検出
・高速、非破壊
・自動計数 5E9 cm-2まで
欠陥数: - 882
貫通転位密度: - 3.1E8 cm-2
欠陥評価:薄膜太陽電池のピンホール検出
超高感度設計により、25x25 um領域の測定を約1分で実現

カソードルミネッセンス強度イメージ
(25x25um、256x256点、
65秒)
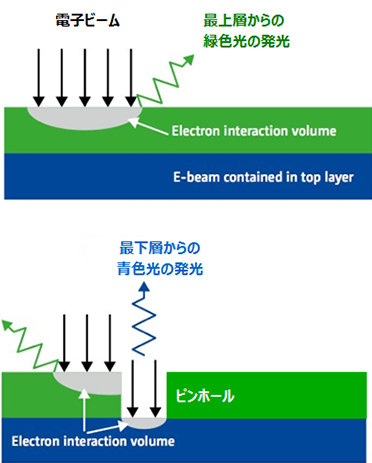
ピンホール欠陥があるとその位置から青色光が発光
Siテクノロジー:Siの点欠陥と線欠陥の同定
InGaAs検出器の搭載により、近赤外領域の測定も可

ZnO NWsの時間分解カソードルミネッセンス測定
パルスレーザーにより電子銃をパルス化することで時間分解測定を実現

窒化ホウ素(BN)の時間/波長分解カソードルミネッセンスイメージ
欠陥評価
新チャネル材料(InPトレンチ)の欠陥検出
Collaboration - IMEC, Unpublished results
パワーデバイス 3C-SiC、4H-SiC
Collaboration – Anvil Semiconductors
GaNテクノロジー
GaNレイヤーのCL分析
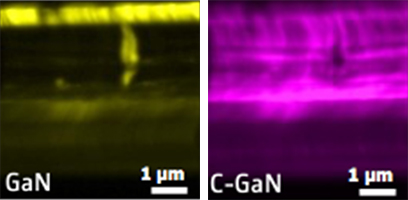
CL強度イメージ

SEMイメージ
測定条件
・128 x 128 点
・10 ms/点
・加速電圧: 7 keV
・室温
GaNテクノロジー
各レイヤー毎の平均Al濃度分析
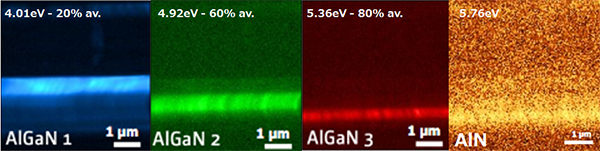
CL強度イメージ

SEMイメージ
GaNテクノロジー
AlGaNレイヤ-のCL分析
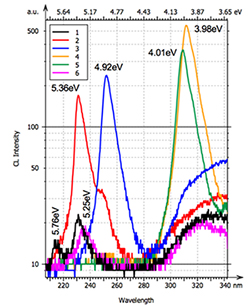
CLスペクトル
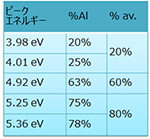
CLピークシフト分析に
基づくAl比率の同定
(精度:1% 以下)
Collaboration - Fraunhofer IMWS
Unpublished results, F. Altmann
GaNテクノロジー
AlGaNバッファーレイヤーの歪みマッピング
故障解析
InGaN/GaN グリーンレーザーダイオード
レーザー(新)の平均CLスペクトル

‘Nanoscale Investigation of Degradation and
Wavelength Fluctuations in InGaN-based
Green Laser Diodes’
IEEE Transactions on
Nanotechnologies 15, 274 (2016)
Collaboration - Univ. Padova & Cagliari
Profs. M. Meneghini, G. Meneghesso, M. Venzi & E. Zanoni
故障解析
CIGS太陽電池の組成変動分析

CLのピーク波長イメージ

CLのFWHMイメージ
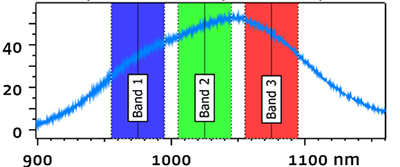
平均CLスペクトル
Collaboration - Empa (Switzerland) B. Bissig
ナノフォトニクス
歪みに起因するバンドギャップシフト (GaN/AlGaN core-shell NWs)

GaN coreのCLスペクトル
AlGaN shellによって誘起されたGaNコアへの圧縮歪みをCLスペクトルで観察
・点1 - 歪み無しGaN
・点2 & 3 - 歪みGaN
→ CLスペクトルが紫外側へシフト
‘Strain-Induced Band Gap Engineering in Selectively Grown GaN–
(Al,Ga)N Core–Shell Nanowire Heterostructures'
Nano Lett. 16, 7098–7106 (2016)
Collaboration - EPFL
A. Fontcuberta i Morral
ナノフォトニクス
局所状態密度イメージングInGaN/GaNマイクロディスクのWhispering gallery modes (WGM)

‘Effect of Threading Dislocations on the Quality Factor
of InGaN/GaN Microdisk Cavities’
ACS Photonics 2, 137-143 (2015)
Collaboration - Univ. Cambridge - T. Zhu & R. Oliver